Time of Flight Secondary Ion Mass Spectrometer (Tof-SIMS)
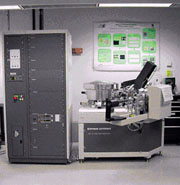 Tof-SIMS is an analytical technique that uses a primary ion beam in an
ultrahigh vacuum environment to probe the surface of a solid
material.
Tof-SIMS is an analytical technique that uses a primary ion beam in an
ultrahigh vacuum environment to probe the surface of a solid
material.
Tof-SIMS provides spectroscopy for:
- Characterization of chemical composition
- Imaging for determining the distribution of chemical species
- Depth profiling for thin film characterization
Performance Capabilities:
- One parameter tuning used for insulating samples
- Library of high mass resolution reference spectra
- High-speed SIMS imaging setup and acquisition
Analytical Applications:
- Statistical analysis of trace (ppm) contamination and multiple defects on silicon wafers and magnetion analysis of surface contamination, drug delivery cross-sec media
- High spatial resolution surface and cross-sectiction samples and failure analysis samples
- Trace sensitivity for routine problem solving of contamination and defects for failure analysis and ultra-thin films
Advantages:
- Elemental and molecular fragment analysis during depth profiling
- Specific compound identification through high mass resolution and mass accuracy
- Non-destructive analysis of the top monolayer
PHI TRIFT II Time-of-Flight SIMS














